設備検索
成膜
転写
エッチング
評価・計測
その他
- ダイシングソー
- 実体顕微鏡 (SZX16-3151:オリンパス製)
- システム工業顕微鏡(BX51M-N33MB:オリンパス製)
- 恒温器(DN400:ヤマト科学製)
- ドラフトチャンバー(酸・アルカリ・有機各2台)
成膜
4元マグネトロンサイドスパッタ装置 CFS-4EP-LL
製造:芝浦メカトロニクス㈱

主な用途・特徴
・ロードロック式タイプのスパッタリング装置
・広範囲に分布が良いスパッタ源を搭載
主な機能とオプション
スパッタ方式:サイドスパッタ
スパッタ源:φ76mm × 4
基板ホルダーサイズ:φ220 mm、面内膜厚バラツキ±5%以内φ170 mm以内(SiO2)
到達圧力:5×10-4 Pa以下
排気時間:10分で7×10-3 Pa以下
加熱温度:最大300℃
ターゲット:ITO、Ti、SiO2、AZO、Ni、Al、TiO2、Cr、Ag、Si、Sn、Au、Pt、Ni-Cr、Ti-Ni、Cuなど
(ターゲットについてはお問い合わせください)
設置場所
NANOBIC CR
ECRイオンビームスパッタ成膜装置 EIS-230W
製造:㈱エリオニクス
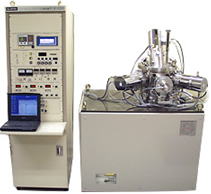
主な用途・特徴
・イオン銃:スパッタ用2本、アシスト用1本、計3本搭載
・多層膜の形成や異種ターゲット構成原子の混ざり合った混合膜の形成が可能
・薄膜形成時にイオンビ-ムミキシングや薄膜形成原子の表面での攪拌、結晶化の促進等が可能
主な機能とオプション
イオン銃:電子サイクロトロン共鳴(ECR)型、スパッタ用1本、アシスト用1本使用可能
イオン化ガス:Ar
加速電圧:10 V~3000 V 連続可変
成膜速度:4 nm/min(Pt)
スパッタ用ビームエネルギー:1,000~3,000 eV
スパッタ用ビームイオン電流密度:±3%/2 Hour
アシスト用ビームエネルギー:10~200 eV
アシスト用ビームイオン電流密度:±3%/1 Hour
イオンビーム有効径:φ20 mm(FWHM35 mm)
ターゲット台:同時装着可能ターゲット数:3個
ターゲットサイズ:100×80 mm
基板ホルダーサイズ:φ100 mm
ターゲット:Ti, Cr, Al, Au, C, Si
設置場所
NANOBIC CR
パリレン蒸着装置 PDS-2010
製造:日本パリレン合同会社

主な用途・特徴
・パリレンコーティング
主な機能とオプション
標準装備蒸着チャンバーサイズ:φ300×H300 mm (有効内容積):φ215 x H270 mm
利用できるパリレン:パリレンN、パリレン C のみ
数百 nm程度の蒸着が可能
設置場所
NANOBIC CR
クラスタ型コータデベロッパ GAMMA
製造:ズース・マイクロテック(株)

主な用途・特徴
・フォトレジストのスピンコート、スプレーコート、現像、ベーク、ベーパープライムを全自動でプロセス可能
・高い均一性、再現性
・25~50枚までのウエハーを連続処理可能
主な機能とオプション
対応基板サイズ:2、3、4インチ、異形基板にも一部対応可能
ウエハーハンドリング:全自動、レシピ作成可能
持ち込みレジストの塗布にも対応
ベイク可能温度範囲:60~250℃
スピンコート均一性:±1.0%以内(膜厚10 μmにおいて)
設置レジスト:OFPR 800LB 23cp、AZP4620
設置場所
NANOBIC YR
スピンコータMS-A100
製造:ミカサ㈱

主な用途・特徴
・レジスト塗布
主な機能とオプション
形式:回転塗布式
試料サイズ:最大φ100 mm × t1 mm
試料固定方式:真空吸着固定式
回転数:50~5000 rpm
設置場所
NANOBIC YR
スピンコータMS-A200
製造:ミカサ㈱

主な用途・特徴
・レジスト塗布
主な機能とオプション
形式:回転塗布式
試料サイズ:最大φ200 mm × t1 mm
試料固定方式:真空吸着固定式
回転数:50~5000 rpm
設置場所
NANOBIC YR
スピンドライヤー SPD-160RN
製造:㈱コクサン

主な用途・特徴
・基板の洗浄、乾燥
・純水での槽内洗浄、N2による仕上げ乾燥が可能
主な機能とオプション
形式:回転塗布式
キャリア:150mm以下 1個掛
回転数:槽内洗浄0~1,500 rpm、ドライ0~3,500 rpm
超純水,N2に接続
設置場所
NANOBIC CR
アッシャー PR510
製造:ヤマト科学㈱

主な用途・特徴
・フォトレジストの除去,部品の洗浄,界面活性処理
・コンパクトタイプのバレル型プラズマ処理装置
主な機能とオプション
方式:DP方式バレル型
反応ガス系:酸素
標準出力200W
設置場所
NANOBIC CR
転写
超高精度電子ビーム描画装置 ELS-7800K
製造:㈱エリオニクス

主な用途・特徴
・高精度・高安定。加速電圧80 kVにより、10 nm以下超ファインパターンを実現
主な機能とオプション
電子銃:ZrO/W熱電界放射型
加速電圧:80 kV、50 kV、25 kV
最小電子ビーム径:Φ2.0 nm(於80 kV)
描画最小線幅:8 nm
ビーム電流強度:5×10-12~2×10-9 A
描画フィールドサイズ:2,400 μm×2,400 μm(25 kV時のみ)、1,200 μm×1,200 μm、600 μm×600 μm、
300 μm×300 μm、150 μm×150 μm、75 μm×75 μm
ビームポジション:最大240,000×240,000(18bit DAC)
ビーム位置決め分解能:0.31 nm(75 μm×75 μmフィールド使用時)
10 nm(2,400 μm×2,400 μmフィールド使用時)
スキャンレート:0.1 μsec/dot~3,200 μsec/dot
フィールドつなぎ精度:40 nm以下
最大試料サイズ:φ150 mmウェハー又はφ150 mm角マスク
設置場所
NANOBIC YR
レーザー直接描画装置 DWL66fs
製造:Heidelberg Instruments Mikrotechnik
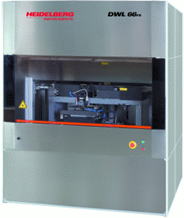
主な用途・特徴
・フォトマスク作製、直描
主な機能とオプション
電子銃:ZrO/W熱電界放射型
加速電圧:80 kV、50 kV、25 kV
光源:Arイオンレーザ 波長:363 nm、出力:180 mW
最大基板サイズ:9 インチ×9 インチ
最大描画サイズ:200×200 mm
最小描画サイズ:1.0 μm
最小アドレス・グリッド: 10 nm
描画スピード:29~416 mm2/分
3D露光モード
アライメント用カメラシステム
データフォーマット:DXF(推奨)、GDSll(推奨)、CIF、Gerber、BMP、Ascii、STL
グレースケール露光対応
設置場所
NANOBIC YR
手動両面マスクアライナ SUSS MA6BSA
製造:ズース・マイクロテック(株)

主な用途・特徴
・回折効果を補正するよう最適化された光学系によりサブミクロンのパターンが転写・形成可能
・ソフトコンタクト、ハードコンタクト、バキュームコンタクトなどが可能
・表面二重露光アライメント精度、表面・裏面アライメント精度ともに、サブミクロンの
精度を有する
・裏面アライメント可能
主な機能とオプション
基板サイズ:不定形小片~φ100 mm
対応基板厚:最大1.5 mm(バキュームコンタクト使用時)
最大3.0 mm(その他の露光モード使用時)
対応マスク厚:1.5mm, 2.3mm(推奨値)
露光モード:プロキシミティ,バキュームコンタクト,ソフトコンタクト,
ハードコンタクトアライメント精度:±0.5 μm(TSA) ±1 μm(BSA)
露光波長:365nm
設置場所
NANOBIC YR
ナノインプリント装置 X-300
製造:SCIVAX㈱

主な用途・特徴
・微細構造成形
主な機能とオプション
形式:熱式、UV式
転写方式:一括転写
最大成形サイズ:φ150 mm(熱式)、100 mm角(UV式)
被転写材料:UV硬化樹脂、熱可塑性樹脂、熱硬化性樹脂
最高使用温度:650℃
最大荷重力:50 kN
ステージ速度:最大15 mm/sec 最小50 nm/sec、任意設定可能、バックラッシュキャンセル機構
最大ワークサイズ:φ150 mm
ワーク保持:真空吸着
UV機能:波長 365 nm/385 nm、有効照射面積 100 mm角、最大加圧力 2 MPa、
最大操作温度 100℃
真空機能:真空チャンバー付属,真空到達圧力 300 Pa
設置場所
NANOBIC CR
エッチング
高密度プラズマドライエッチング装置 NLD-570
製造:アルバック㈱

主な用途・特徴
・石英などのドライエッチング
・磁気中性線プラズマ(NLD)による低圧・低電子温度・高密度プラズマを搭載した
ドライエッチング装置
・パイレックスやホウケイ酸ガラスなど不純物の多いガラス加工も形状や表面平滑性に
優れたエッチングが可能
・石英やガラスのディープエッチング(100 μm以上)にもマスクとして厚膜レジストの
使用が可能
・高速エッチングが可能(石英>1 μm/min、Pyrex>0.8 μm/min)
主な機能とオプション
プラズマ源:磁気中性線プラズマ(NLD)
基板サイズ:φ150 mm
基板ステージ:メカチャック、チラー温度制御(-20~40℃)、He冷却機構
高周波電源:アンテナ:2 kW(13.56 MHz)、バイアス:600 W(12.5 MHz)
排気系:エッチング室:TMP(2800 L/sec)+DRP
ガス導入系:CHF3、C3F8、SF6、O2、Ar、N2、He
用途 :石英のみ、石英以外は要相談
その他:ロードロック室
設置場所
NANOBIC CR
誘導結合プラズマドライエッチング装置PlasmaPro100 ICP-180
製造:オックスフォード・インストゥルメンツ㈱

主な用途・特徴
・InP, InGaAs, InAlAs等のIII-V化合物のドライエッチング
主な機能とオプション
プラズマ源:誘導結合プラズマ(ICP)
上部電極 周波数:13.56 MHz、最大出力3 kW
下部電極 周波数:13.56 MHz、最大出力300 W、温度制御(20~400℃)
基板サイズ:φ100 mm 小片チップはφ100 mmのシリコンウェーハに載せることで処理可能
ガス導入系:SF6、CH4、Cl2、H2、O2、Ar、N2、He
用途 :InP、 InGaAs、 InAlAs等のIII-V化合物
その他:ロードロック室
設置場所
NANOBIC CR
集束イオンビーム加工観察装置 FB-2200
製造:㈱日立ハイテクノロジ-ズ
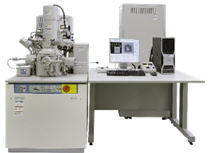
主な用途・特徴
・TEM試料作製、大面積加工
最大ビーム電流 60 nAにより、加工の高速化と大面積加工を実現
・低加速電圧による低ダメージ試料作製
・マイクロサンプリングによるピンポイント薄膜試料作製
主な機能とオプション
加速電圧:2~40 kV
最大ビーム電流:60 nA以上
最大ビーム電流密度:50 A/cm2以上
像分解能:6 nm以下(加速電圧40 kV)
倍率(ディスプレイ上):60~300,000倍
イオン源:Ga
対物レンズ絞り:電動切替式
レンズ・偏向器:静電2段式レンズ・8極静電式
試料サイズ:φ100×h17 mm
加工機能:BOX加工、任意形状加工
画像取得:最大2,000 × 2,000 ピクセル
設置場所
NANOBIC CR
シリコン深掘りDRIE装置 MUC-21
製造:住友精密工業(株)
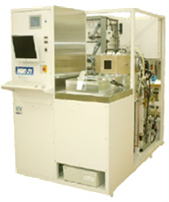
主な用途・特徴
・ボッシュプロセスを用いた高アスペクト比シリコンエッチング
主な機能とオプション
対応基板サイズ:φ100 mm
エッチレート:~5 μm/min
アスペクト比:~40
面内均一性: <±5%
SOIノッチフリーテクノロジー搭載
ランプドプラテンコントロール搭載
メタルマスクの利用可能
設置場所
NANOBIC CR
評価・計測
雰囲気制御型熱電子放出型走査電子顕微鏡 Quanta250/EDS
製造:㈱日本FEI

主な用途・特徴
・水分量コントロール(ウェット観察)、高温加熱観察、高真空SEM観察
主な機能とオプション
電子銃:タングステン
分解能:3.0 nm(高真空:高加速電圧30 kV)
8.0 nm(低真空:低加速電圧3 kV)
3.0 nm(ESEM)
試料室真空度:6×10-4 Pa(高真空)
10~130 Pa(低真空)
10~2600 Pa(ESEM)
加速電圧:0.2~30 kV
照射電流:最大2 mA
倍率:x6~1,000,000
試料交換:ドローアウト方式
試料サイズ:最大φ100 mm、H50 mm
検出器:二次電子検出器:ETD(シンチレータ型)(高真空)
LF-GSED(広視野型)(低真空)
GSE型(超低真空)
半導体反射電子検出器
付属装置:赤外線CCDカメラ、加熱ステージ(最高1000℃)、冷却ステージ(-20~+60℃)
EDS(オックスフォード・インストゥルメンツ㈱)INCA Energy250 x-act
設置場所
NANOBIC CR
原子間力顕微鏡 Dimension Icon
製造:ブルカージャパン(株)
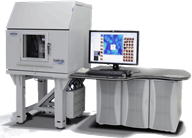
主な用途・特徴
・大型試料用走査型プローブ顕微鏡
・高分解能と低ドリフトを実現
・ScanAsyst機能やPeakForce QNM機能を実現
主な機能とオプション
x-yスキャン範囲:85×85 mm、z範囲:9 mm
試料サイズ:最大φ210 mm、H15 mm
モード:コンタクトモード、ノンコンタクトモード、ACモード(タッピングモード)、
捩れ共振モード(TR)
機能:ナノリソグラフィー(陽極酸化、スクラッチ)、ナノインデンテーション、
電気力(EFM)、磁気力(MFM)
設置場所
KBIC 102号室
3Dリアルサーフェスビュー顕微鏡 VE-8800
製造: ㈱キーエンス

主な用途・特徴
・SEM観察
・低加速電圧観察対応で、非導電性試料でも非蒸着で観察可能
・2枚の視差画像から高精度に3D像を構築
主な機能とオプション
倍率:15~100000倍
観察範囲:9(H)×7(V) mm~1.3(H)×1(V) mm
分解能:30 nm
観察像:2次電子像・反射電子像
観察モード:高真空・低真空(3~260 Pa)
表示分解能:観察時640(H)×480(V)、撮影時1280(H)×960(V)
フレームレート:4.5 F/S(観察時)
加速電圧:0.5 kV~20 kV
電子銃:タングステンヘアピン・アジャストメントフリーカートリッジ式
最大試料サイズ:φ64 mm
試料ステージ:5軸(X・Y・Z・回転・傾斜)、ユーセントリック式(XY軸電動)
X:32 mm・Y:32 mm・Z:8~30 mm・回転:360°・傾斜:-10~+90°
設置場所
KBIC 102号室
断面試料作製装置 SM-09020
製造: 日本電子㈱

主な用途・特徴
・表面に対して垂直な断面作製
・銅、アルミ、金、はんだ、高分子、セラミック、ガラスなどの試料加工
・EDS、WDS分析用の試料、多層膜の形状観察や膜厚測定、粒子の方位解析(EBSD)
などのための試料作製
主な機能とオプション
イオン加速電圧:2~6 kV
イオンビーム径:500 mm(半値幅)
ミリングスピード:1.3 mm/min (加速電圧:6kV、シリコン換算、エッジ距離:100 mm)
最大搭載試料サイズ:幅11 mm × 長さ10 mm × 厚さ2 mm
試料移動範囲:X軸:±3 mm、Y軸:±3 mm
使用ガス:アルゴンガス
圧力測定:ペニング真空計
設置場所
KBIC 102号室
共焦点レーザー顕微鏡
製造: ライカマイクロシステムズ㈱

主な用途・特徴
・蛍光観察
・生細胞の超解像イメージングへの応用が可能
主な機能とオプション
対物レンズ:x10、x63 oil、x100 oil
最大走査画素数:1024×1024 画素
共焦点可視光レーザー:波長458、476、488、496、514、633 nm
記録速度:20 フレーム/秒
検出器:APD
設置場所
KBIC 102号室
自動比表面積/細孔分布装置 アサップ2020
製造: ライカマイクロシステムズ㈱

主な用途・特徴
・ナノ~サブナノ領域の細孔分布測定
主な機能とオプション
測定方式:定容法によるガス吸着法
測定レンジ:測定範囲0~127 kPa(950 mmHg)
測定部分解能:127 kPa(950 mmHg)レンジ0.133 Pa(0.001 mmHg)以下
1.333 kPa(10 mmHg)レンジ 1.33 mPa(0.00001 mmHg)以下
133.3 Pa(1 mmHg)レンジ 0.133 mPa(0.000001 mmHg)以下
測定部精度:127 kPa(950 mmHg)レンジ 読みの ±0.15%以内
1.333 kPa(10 mmHg)レンジ 読みの ±0.15%以内
133.3 Pa(1 mmHg)レンジ 読みの ±0.12%以内
比表面積測定範囲:0.001 m2/g以上(クリプトンガス使用時)
メソポア分布測定範囲:直径 約1~100 nm(窒素・BJH法の場合)
マイクロポア分布測定範囲:直径 約0.4~2 nm
使用ガス:窒素、クリプトン、アルゴン他
ソフトウェア解析項目:
(1)化学吸着測定:金属表面積、化学吸着熱、金属分散率、結晶粒径
(2)物理吸着測定:多点法・1点法BET比表面積、Langmuir比表面積、Temkin/Freundich
等温線解析、BJH法によるメソポア+マクロポア分布、全細孔容積、平均細孔径、MP法による
マイクロポア細孔分布、tプロット法、αsプロット法マイクロポア解析、標準等温線の
設定可能(t,αs,BJH各手法)、f-Ratioプロットによる等温線比較、微分吸着熱解析
Dubinin-Radushkevich(D-R)解析、Dubinin-Asrakhov(D-A)解析、DFT解析
(3)マイクロポア測定:Horbath-Kawazoe(H-K)解析、球形細孔用Cheng-Yang(C-Y)解析、
円筒細孔用Saito-Foley(S-F)解析
設置場所
NANOBIC 1008号室
超高解像度表面形状計測装置 WYKO NT9100A
製造: ブルカージャパン(株)

主な用途・特徴
・3次元表面形状計測
・サンプル表面の形状や粗さを非接触で三次元的に測定することが可能
・測定面内において、輝度差が大きいものや、低反射率材料、透明材料でも問題なく計測が可能
主な機能とオプション
測定モード:垂直走査干渉測定(VSI方式)
Z方向測定レンジ:0.1 nm~10 mm
分解能:0.1 nmRa(位相シフト干渉測定時)
対物レンズ:x 5、x 50
試料ステージ:150 mm角
動的評価測定(対応周波数領域:11 Hz~2.4 MHz)
膜厚評価(膜厚:2~200 mm、z方向分解能:5 nm)
設置場所
NANOBIC CR
表面張力接触角計 Drop Master DM500
製造: 協和界面科学㈱

主な用途・特徴
・接触角、表面張力測定
主な機能とオプション
計測システム:CCDカメラ
測定方法:液滴法(接触角)
懸滴法(表面張力)
解析方法:接触角(θ/2法、真円フィット法、楕円フィット法)
表面張力(Young-Laplace法)
測定範囲:0~180°(接触角)
0~80 mN/m(表面張力)
測定精度:±1°(接触角、θ/2法)
表示分解能:0.1°(接触角)
0.1 mN/m(表面張力)
設置場所
NANOBIC CR
ガス透過率度測定装置 GTR-21AXKUDM500
製造: GTRテック㈱

主な用途・特徴
・単一ガス、混合ガスの透過率の測定
主な機能とオプション
試験対象ガス:窒素、酸素ガス、炭酸ガス、混合ガス、水蒸気
試験ガス供給圧力:-100~600 kPa
試験片サイズ:透過面積15.2 cm2(φ44 mm)
調湿範囲:0~100%
セル温度調整範囲:10℃~80℃
検出方式:TCD付ガスクロマトグラフ検量線方式
設置場所
NANOBIC 1008号室
光干渉式膜厚測定装置 VM-1200
製造: 大日本スクリーン製造㈱

主な用途・特徴
・膜厚計測
・最大4層膜までの積層膜同時測定が可能
主な機能とオプション
分光器:平坦結像型凹面ホログラフィック・グレーティング、1次元CCDイメージセンサ
対物レンズ:x10
試料サイズ:φ200 mm以下
膜厚測定範囲:10~40,000 nm(x 10時)
精度:0.1 nm
設置場所
NANOBIC YR
レーザー顕微鏡 VK-8510
製造: ㈱キーエンス

主な用途・特徴
・形状計測
主な機能とオプション
最高空間分解能:垂直・水平方向ともに0.01mm
表示分解能:962 × 729 ピクセル (カラー)、1024 × 768 ピクセル (モノクロ)
フレームメモリ:1024×768×8 bit×3 フレーム (カラー)、1024×768×8 bit (モノクロ)、
1024×768×20 bit (高さ分析)
フレームレート:6 Hz (カラー)、9 Hz (モノクロ)、1 kHz (ラインおよび膜厚)
観察用光源:50 W ハロゲンランプ, 色温度 3000 K
測定用光源:半導体レーザ、波長 685 nm、出力 0.45 mW
設置場所
NANOBIC CR
触針式表面形状測定器 DEKTAK XT-A
製造: ブルカージャパン㈱製

主な用途・特徴
・二次元表面粗さ特性分析および段差の計測
主な機能とオプション
触針圧1~15mgに任意に設定可能
X,Y方向、回転方向(θ)へ360度位置決め可能
サンプル厚50mm
測定距離最大150mm
φ150mmまでのサンプルに対応
6.5um、65.5um、524um、1mmの4レンジ付近での厚さ測定に対応
設置場所
NANOBIC CR
卓上電子顕微鏡 TM3000
製造: 株式会社日立ハイテク製

主な用途・特徴
・走査型電子顕微鏡
主な機能とオプション
加速電圧: 5, 15kV
検出器:BSE
最大倍率: 10k
最大試料サイズ:70mmΦ
設置場所
NANOBIC CR
その他
ダイシングソー DAD522
製造: 株式会社ディスコ

主な用途・特徴
・シリコン・ガラス・セラミックなどの被加工物をブレードを用いて高精度に切断
主な機能とオプション
対応基板:φ150 mmまで
カッティング部:X軸(チャックテーブル左右動)
Y軸(スピンドル前後動)
切削可能範囲:220mm(x)×160mm(y)
最大ストローク:X軸325mm,Y軸162mm
スピンドルZ軸移動分解能:0.0001mm
回転数範囲:3000-40000 rpm
顕微鏡:対物5倍
設置場所
NANOBIC CR